
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Metode Debonding Arus Utama
Dengan kemajuan pemrosesan semikonduktor dan meningkatnya permintaan komponen elektronik, penerapan wafer ultra tipis (ketebalan kurang dari 100 mikrometer) menjadi semakin penting. Namun, dengan terus berkurangnya ketebalan wafer, wafer sangat rentan terhadap kerusakan selama proses selanjutnya, seperti penggilingan, etsa, dan metalisasi.
Teknologi pengikatan dan pelepasan ikatan sementara biasanya diterapkan untuk menjamin kinerja stabil dan hasil produksi perangkat semikonduktor. Wafer ultra-tipis untuk sementara dipasang pada substrat pembawa yang kaku, dan setelah pemrosesan bagian belakang, keduanya dipisahkan. Proses pemisahan ini dikenal sebagai debonding, yang terutama mencakup debonding termal, debonding laser, debonding kimia, dan debonding mekanis.
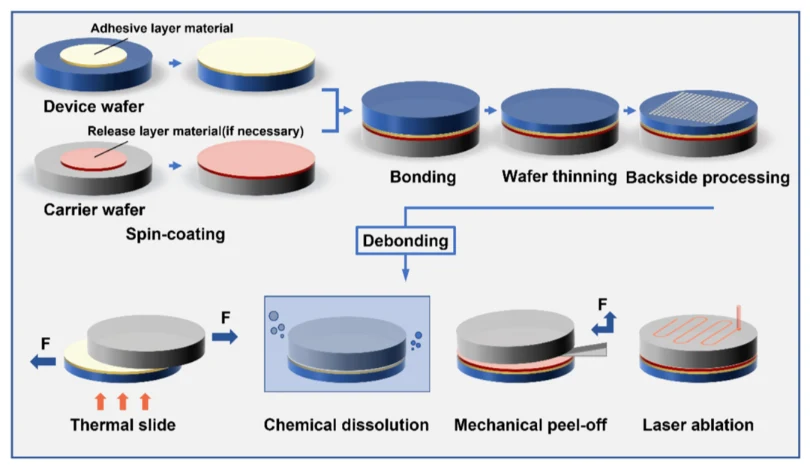
Debonding Termal
Debonding termal adalah metode yang memisahkan wafer ultra-tipis dari substrat pembawa dengan memanaskan untuk melunakkan dan menguraikan perekat pengikat, sehingga kehilangan daya rekatnya. Hal ini terutama dibagi menjadi debonding slide termal dan debonding dekomposisi termal.
Debonding slide termal biasanya melibatkan pemanasan wafer yang direkatkan hingga suhu pelunakannya, yang berkisar antara 190°C hingga 220°C. Pada suhu ini, perekat pengikat kehilangan daya rekatnya, dan wafer ultra-tipis dapat terdorong atau terkelupas secara perlahan dari substrat pembawa akibat gaya geser yang diterapkan oleh perangkat sepertichuck vakumuntuk mencapai pemisahan yang mulus. Sedangkan pada debonding dekomposisi termal, wafer yang terikat dipanaskan ke suhu yang lebih tinggi, menyebabkan dekomposisi kimia (pemotongan rantai molekul) perekat dan kehilangan daya rekatnya sepenuhnya. Hasilnya, wafer yang terikat dapat terlepas secara alami tanpa adanya gaya mekanis apa pun.
Penguraian ikatan laser
Debonding laser adalah metode debonding yang memanfaatkan penyinaran laser pada lapisan perekat wafer yang diikat. Lapisan perekat menyerap energi laser dan menghasilkan panas, sehingga mengalami reaksi fotolitik. Pendekatan ini memungkinkan pemisahan wafer ultra-tipis dari substrat pembawa pada suhu kamar atau suhu yang relatif rendah.
Namun, prasyarat penting untuk pelepasan ikatan laser adalah substrat pembawa harus transparan terhadap panjang gelombang laser yang digunakan. Dengan cara ini, energi laser berhasil menembus substrat pembawa dan diserap secara efektif oleh material lapisan pengikat. Untuk alasan ini, pemilihan panjang gelombang laser sangat penting. Panjang gelombang tipikal meliputi 248 nm dan 365 nm, yang harus disesuaikan dengan karakteristik serapan optik bahan pengikat.
Debonding Kimia
Debonding kimia mencapai pemisahan wafer yang terikat dengan melarutkan lapisan perekat pengikat dengan pelarut kimia khusus. Proses ini memerlukan molekul pelarut yang menembus lapisan perekat untuk menyebabkan pembengkakan, pemotongan rantai, dan akhirnya pembubaran, yang memungkinkan wafer ultra-tipis dan substrat pembawa terpisah secara alami. Oleh karena itu, tidak diperlukan peralatan pemanas tambahan atau tenaga mekanis yang disediakan oleh pencekam vakum, pelepasan ikatan kimia menghasilkan tekanan minimal pada wafer.
Dalam metode ini, wafer pembawa sering kali dibor terlebih dahulu untuk memungkinkan pelarut bersentuhan sepenuhnya dan melarutkan lapisan pengikat. Ketebalan perekat mempengaruhi efisiensi dan keseragaman penetrasi dan pelarutan pelarut. Perekat pengikat larut sebagian besar merupakan bahan berbasis termoplastik atau polimida yang dimodifikasi, biasanya diaplikasikan dengan pelapisan spin.
Debonding Mekanis
Debonding mekanis memisahkan wafer ultra-tipis dari substrat pembawa sementara secara eksklusif dengan menerapkan kekuatan pengelupasan mekanis yang terkontrol, tanpa panas, pelarut kimia, atau laser. Prosesnya mirip dengan pengelupasan selotip, yaitu wafer “diangkat” secara perlahan melalui pengoperasian mekanis yang presisi.
Semicorex menawarkan kualitas tinggiChuck Debonding Keramik Berpori SIC. Jika Anda memiliki pertanyaan atau memerlukan detail tambahan, jangan ragu untuk menghubungi kami.
Hubungi telepon #+86-13567891907
Email: penjualan@semicorex.com




