
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Apa Proses LPCVD?
Proses deposisi uap kimia bertekanan rendah (LPCVD) adalah teknik CVD yang mendepositkan bahan film tipis pada permukaan wafer di bawah lingkungan bertekanan rendah. Proses LPCVD banyak digunakan dalam teknologi pengendapan material untuk manufaktur semikonduktor, optoelektronik, dan sel surya film tipis.
Proses reaksi LPCVD biasanya dilakukan dalam ruang reaksi bertekanan rendah, biasanya pada tekanan 1–10 Torr. Setelah wafer dipanaskan hingga kisaran suhu yang sesuai untuk reaksi pengendapan, prekursor gas dimasukkan ke dalam ruang reaksi untuk pengendapan. Gas-gas reaktif tersebut berdifusi ke permukaan wafer dan kemudian mengalami reaksi kimia pada permukaan wafer pada kondisi suhu tinggi membentuk endapan padat (film tipis).
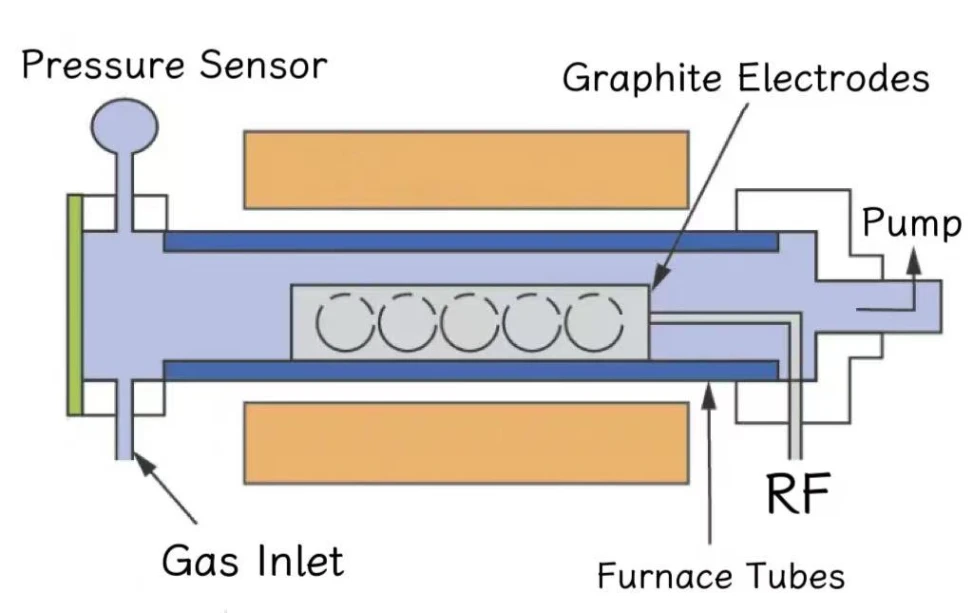
Keuntungan dari proses LPCVD
1. Kualitas deposisi film tipis berkualitas tinggi
Laju transpor gas reaktan dipercepat ketika tekanan rendah karena koefisien difusi gas meningkat. Dengan demikian, distribusi molekul gas yang lebih seragam dapat tercipta di seluruh ruang reaksi, yang memastikan bahwa molekul gas bereaksi sepenuhnya dengan permukaan wafer dan secara signifikan mengurangi rongga atau perbedaan ketebalan yang disebabkan oleh reaksi yang tidak lengkap.
2. Cakupan langkah film ini sangat bagus
Kemampuan difusi gas yang ditingkatkan pada tekanan rendah memungkinkannya menembus jauh ke dalam struktur yang kompleks. Hal ini memastikan bahwa gas reaktif bersentuhan penuh dengan tangga dan parit pada permukaan wafer, sehingga menghasilkan deposisi lapisan tipis yang seragam. Hasilnya, pengendapan film tipis pada struktur rumit merupakan aplikasi yang baik untuk metode LPCVD.
3. Pengendalian operasional yang kuat
Proses LPCVD menunjukkan kemampuan pengendalian yang kuat selama pengoperasian sebenarnya. Komposisi, struktur, dan ketebalan film tipis dapat dikontrol secara tepat dengan menyesuaikan parameter gas reaktan seperti jenis, laju aliran, suhu, dan tekanan. Peralatan LPCVD memiliki investasi dan biaya operasional yang relatif rendah dibandingkan dengan teknologi pengendapan lainnya, sehingga cocok untuk produksi industri skala besar. Dan konsistensi proses selama produksi massal dapat dipastikan secara efektif dengan sistem otomatis yang memantau dan menyesuaikan secara real time.
Kekurangan proses LPCVD
Karena proses LPCVD biasanya dilakukan pada suhu tinggi, yang membatasi penerapan beberapa bahan yang sensitif terhadap suhu, wafer yang perlu diproses dengan LPCVD harus tahan panas. Selama proses LPCVD, masalah yang tidak diinginkan mungkin muncul, seperti deposisi wafer wrap-around (lapisan tipis yang disimpan di area non-target wafer) dan kesulitan dengan doping in-situ, yang memerlukan pemrosesan lebih lanjut untuk menyelesaikannya. Selain itu, konsentrasi prekursor uap yang rendah pada kondisi tekanan rendah dapat menyebabkan laju deposisi film tipis yang lebih rendah, sehingga mengakibatkan efisiensi produksi yang tidak efisien.
Semicorex menawarkan kualitas tinggiSiC ftabung gucis, SiC dayung kantileverDanperahu wafer SiCuntuk proses LPCVD. Jika Anda memiliki pertanyaan atau memerlukan detail tambahan, jangan ragu untuk menghubungi kami.
Hubungi telepon #+86-13567891907
Email: penjualan@semicorex.com





