
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Pengertian Teknologi Dry Etching pada Industri Semikonduktor
Etsa mengacu pada teknik menghilangkan material secara selektif melalui cara fisik atau kimia untuk mencapai pola struktural yang dirancang.
Saat ini, banyak perangkat semikonduktor menggunakan struktur perangkat mesa, yang sebagian besar dibuat melalui dua jenis pengetsaan:etsa basah dan etsa kering. Meskipun etsa basah yang sederhana dan cepat memainkan peran penting dalam fabrikasi perangkat semikonduktor, namun memiliki kelemahan yang melekat seperti etsa isotropik dan keseragaman yang buruk, yang mengakibatkan terbatasnya kontrol saat mentransfer pola berukuran kecil. Etsa kering, dengan anisotropi tinggi, keseragaman yang baik, dan kemampuan pengulangan, telah menjadi hal yang menonjol dalam proses fabrikasi perangkat semikonduktor. Istilah “pengetsaan kering” secara luas mengacu pada teknologi pengetsaan non-basah yang digunakan untuk menghilangkan material permukaan dan mentransfer pola mikro dan nano, termasuk pengetsaan laser, pengetsaan plasma, dan pengetsaan uap kimia. Etsa kering yang dibahas dalam teks ini secara khusus berkaitan dengan penerapan sempit proses yang menggunakan pelepasan plasma—baik fisik maupun kimia—untuk memodifikasi permukaan material. Ini mencakup beberapa teknologi etsa industri yang umum, termasukEtsa Berkas Ion (IBE), Etsa Ion Reaktif (RIE), Etsa plasma Resonansi Elektron Siklotron (ECR), dan Etsa Plasma Berpasangan Induktif (ICP).
1. Etsa Berkas Ion (IBE)
Juga dikenal sebagai penggilingan ion, IBE dikembangkan pada tahun 1970an sebagai metode etsa fisik murni. Prosesnya melibatkan berkas ion yang dihasilkan dari gas inert (seperti Ar, Xe) yang dipercepat oleh tegangan untuk membombardir permukaan material target. Ion-ion tersebut mentransfer energi ke atom-atom di permukaan, menyebabkan atom-atom yang memiliki energi melebihi energi ikatnya akan tergagap. Teknik ini menggunakan tegangan yang dipercepat untuk mengontrol arah dan energi berkas ion, menghasilkan anisotropi etsa yang sangat baik dan kemampuan pengendalian laju. Meskipun ideal untuk mengetsa bahan yang stabil secara kimia seperti keramik dan logam tertentu, kebutuhan akan masker yang lebih tebal untuk mengetsa lebih dalam dapat mengurangi presisi pengetsaan, dan pemboman ion berenergi tinggi dapat menyebabkan kerusakan listrik yang tidak dapat dihindari karena gangguan kisi.

2. Etsa Ion Reaktif (RIE)
Dikembangkan dari IBE, RIE menggabungkan reaksi kimia dengan pemboman ion fisik. Dibandingkan dengan IBE, RIE menawarkan tingkat etsa yang lebih tinggi dan anisotropi yang sangat baik serta keseragaman di area yang luas, menjadikannya salah satu teknik etsa yang paling banyak digunakan dalam fabrikasi mikro dan nano. Prosesnya melibatkan penerapan tegangan frekuensi radio (RF) ke elektroda pelat paralel, menyebabkan elektron di dalam ruangan mempercepat dan mengionisasi gas reaksi, sehingga menghasilkan keadaan plasma yang stabil di satu sisi pelat. Plasma membawa potensial positif karena elektron tertarik ke katoda dan dibumikan di anoda, sehingga menciptakan medan listrik melintasi ruangan. Plasma bermuatan positif berakselerasi menuju substrat yang terhubung dengan katoda, dan secara efektif mengetsanya.
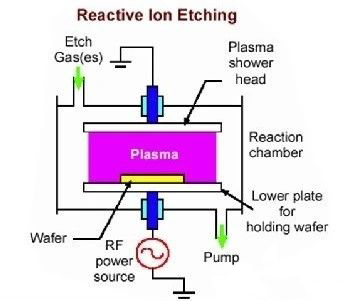
Selama proses etsa, ruangan mempertahankan lingkungan bertekanan rendah (0,1~10 Pa), yang meningkatkan laju ionisasi gas reaksi dan mempercepat proses reaksi kimia pada permukaan substrat. Secara umum, proses RIE memerlukan produk sampingan reaksi yang mudah menguap agar dapat dihilangkan secara efisien oleh sistem vakum, sehingga memastikan presisi etsa yang tinggi. Tingkat daya RF secara langsung menentukan kepadatan plasma dan tegangan bias percepatan, sehingga mengontrol laju etsa. Namun, seiring dengan peningkatan kepadatan plasma, RIE juga meningkatkan tegangan bias, yang dapat menyebabkan kerusakan kisi dan mengurangi selektivitas masker, sehingga menimbulkan keterbatasan dalam aplikasi etsa. Dengan pesatnya perkembangan sirkuit terpadu skala besar dan berkurangnya ukuran transistor, terdapat permintaan yang lebih besar untuk presisi dan rasio aspek dalam fabrikasi mikro dan nano, yang mengarah pada munculnya teknologi etsa kering berbasis plasma dengan kepadatan tinggi, yang menyediakan teknologi etsa kering berbasis plasma dengan kepadatan tinggi. peluang baru bagi kemajuan teknologi informasi elektronik.
3. Etsa Plasma Resonansi Siklotron Elektron (ECR).
Teknologi ECR, metode awal untuk mencapai plasma kepadatan tinggi, menggunakan energi gelombang mikro untuk beresonansi dengan elektron di dalam ruangan, ditingkatkan dengan medan magnet yang disesuaikan dengan frekuensi yang diterapkan secara eksternal untuk menginduksi resonansi siklotron elektron. Metode ini mencapai kepadatan plasma yang jauh lebih tinggi dibandingkan RIE, sehingga meningkatkan laju pengetsaan dan selektivitas masker, sehingga memfasilitasi pengetsaan struktur rasio aspek ultra-tinggi. Namun, kompleksitas sistem, yang bergantung pada fungsi terkoordinasi dari sumber gelombang mikro, sumber RF, dan medan magnet, menimbulkan tantangan operasional. Munculnya etsa Induktif Coupled Plasma (ICP) segera menyusul sebagai penyederhanaan ECR.
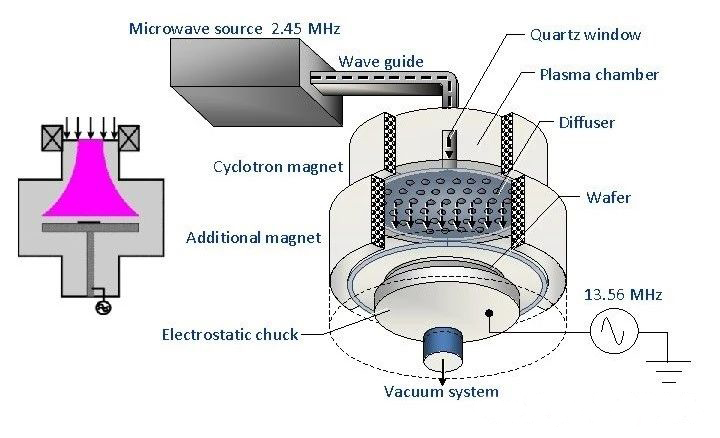
4. Etsa Plasma Berpasangan Induktif (ICP).
Teknologi etsa ICP menyederhanakan sistem berdasarkan teknologi ECR dengan menggunakan dua sumber RF 13,56MHz untuk mengontrol pembangkitan plasma dan tegangan bias akselerasi. Alih-alih medan magnet luar yang digunakan dalam ECR, kumparan spiral menginduksi medan elektromagnetik bolak-balik, seperti yang ditunjukkan pada skema. Sumber RF mentransfer energi melalui kopling elektromagnetik ke elektron internal, yang bergerak dalam gerakan siklotron di dalam medan induksi, bertabrakan dengan gas reaksi sehingga menyebabkan ionisasi. Pengaturan ini mencapai kepadatan plasma yang sebanding dengan ECR. Pengetsaan ICP menggabungkan keunggulan berbagai sistem pengetsaan, memenuhi kebutuhan akan laju penggoresan yang tinggi, selektivitas tinggi, keseragaman area yang luas, dan struktur peralatan yang sederhana dan dapat dikontrol, sehingga dengan cepat menjadi pilihan utama bagi generasi baru teknologi pengetsaan plasma densitas tinggi. .
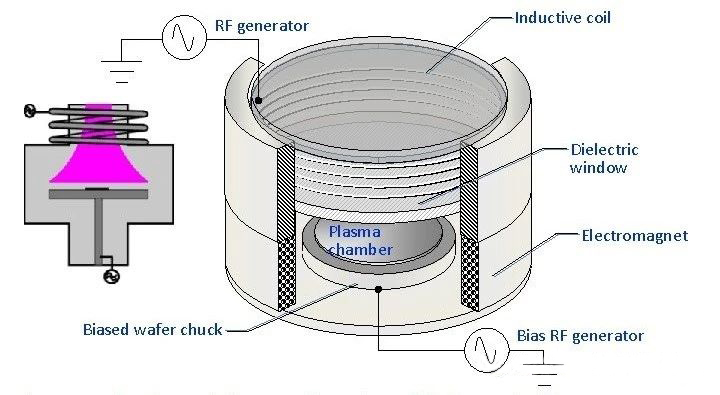
5. Karakteristik Etsa Kering
Teknologi etsa kering dengan cepat mengambil posisi utama dalam fabrikasi mikro dan nano karena keunggulan anisotropi dan laju etsa yang tinggi, menggantikan etsa basah. Kriteria untuk mengevaluasi teknologi etsa kering yang baik meliputi selektivitas masker, anisotropi, laju etsa, keseragaman keseluruhan, dan kehalusan permukaan akibat kerusakan kisi. Dengan banyak kriteria evaluasi, situasi spesifik harus dipertimbangkan berdasarkan kebutuhan fabrikasi. Indikator paling langsung dari etsa kering adalah morfologi permukaan, termasuk kerataan lantai dan dinding samping yang tergores serta anisotropi teras yang tergores, yang keduanya dapat dikontrol dengan menyesuaikan rasio reaksi kimia terhadap pemboman fisik. Karakterisasi mikroskopis setelah etsa biasanya dilakukan dengan menggunakan pemindaian mikroskop elektron dan mikroskop gaya atom. Selektivitas masker, yang merupakan rasio kedalaman pengetsaan masker terhadap material pada kondisi dan waktu pengetsaan yang sama, sangatlah penting. Secara umum, semakin tinggi selektivitasnya, semakin baik keakuratan transfer polanya. Masker umum yang digunakan dalam etsa ICP meliputi photoresist, logam, dan film dielektrik. Photoresist memiliki selektivitas yang buruk dan dapat terdegradasi pada suhu tinggi atau pemboman energik; logam menawarkan selektivitas tinggi tetapi menimbulkan tantangan dalam pelepasan masker dan sering kali memerlukan teknik penyembunyian berlapis-lapis. Selain itu, masker logam mungkin menempel pada dinding samping selama proses pengetsaan, sehingga membentuk jalur kebocoran. Oleh karena itu, pemilihan teknologi masker yang tepat sangat penting untuk pengetsaan, dan pemilihan bahan masker harus ditentukan berdasarkan persyaratan kinerja spesifik perangkat.**




