
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislokasi pada kristal SiC
Substrat SiC dapat memiliki cacat mikroskopis, seperti Threading Screw Dislocation (TSD), Threading Edge Dislocation (TED), Base Plane Dislocation (BPD), dan lain-lain. Cacat ini disebabkan oleh penyimpangan susunan atom pada tingkat atom.
Kristal SiC biasanya tumbuh sejajar dengan sumbu c atau sedikit miring dengannya, yang berarti bidang c juga dikenal sebagai bidang dasar. Ada dua jenis dislokasi utama dalam kristal. Ketika garis dislokasi tegak lurus terhadap bidang dasar, kristal mewarisi dislokasi dari kristal benih ke dalam kristal yang tumbuh epitaksi. Dislokasi ini dikenal sebagai dislokasi penetrasi dan dapat dikategorikan menjadi dislokasi tepi ulir (TED) dan dislokasi ulir ulir (TSD) berdasarkan orientasi vektor Bernoulli terhadap garis dislokasi. Dislokasi yang garis dislokasi dan vektor Brönsted berada pada bidang dasar disebut dislokasi bidang dasar (BPD). Kristal SiC juga dapat mengalami dislokasi komposit, yang merupakan kombinasi dari dislokasi di atas.
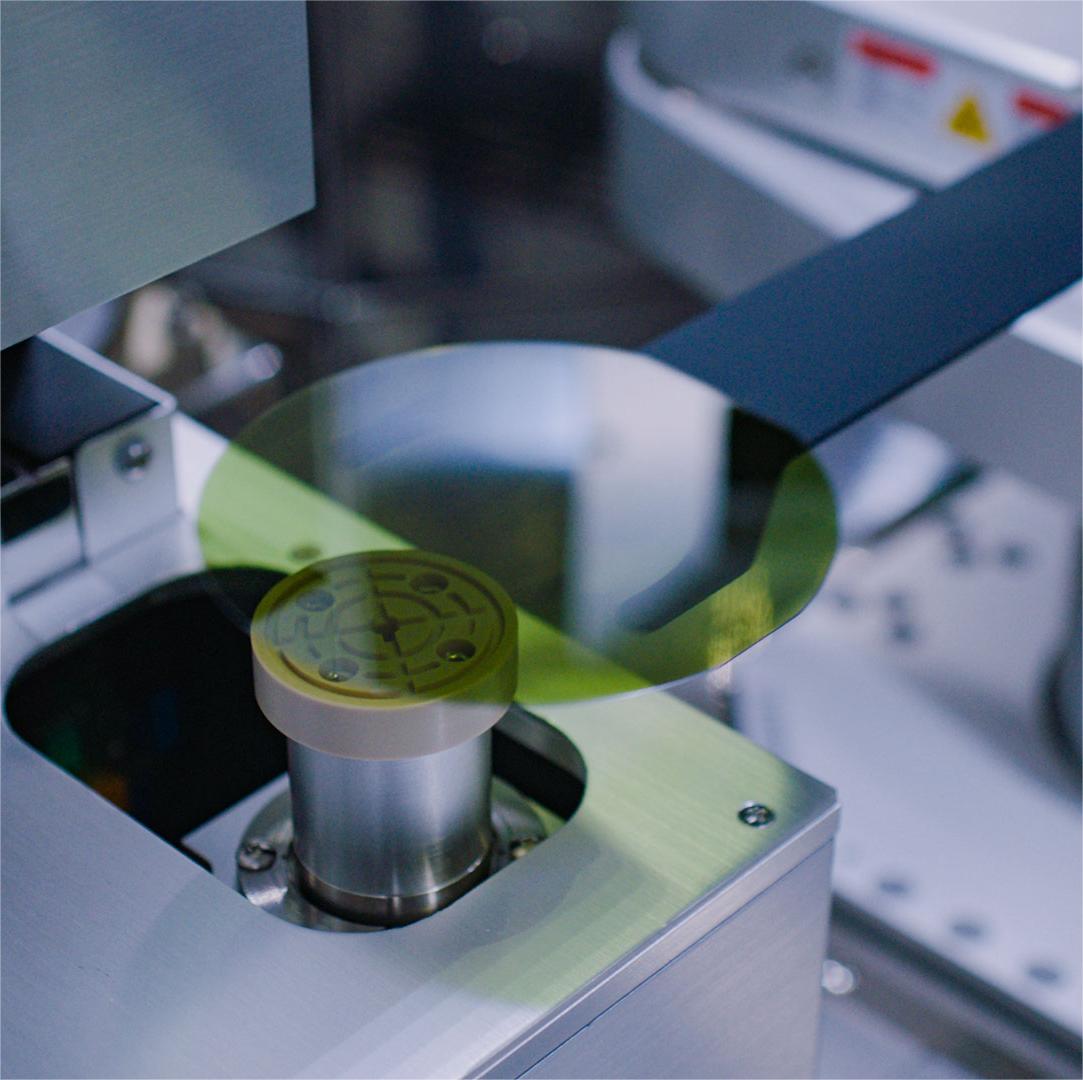
1.TED&TSD
Dislokasi berulir (TSD) dan dislokasi tepi berulir (TED) berjalan di sepanjang sumbu pertumbuhan [0001] dengan vektor Burger yang berbeda masing-masing <0001> dan 1/3<11-20>.
TSD dan TED dapat meluas dari substrat ke permukaan wafer dan menghasilkan fitur permukaan seperti lubang kecil. Biasanya, kepadatan TED adalah sekitar 8.000-10.000 1/cm2, yang hampir 10 kali lipat kepadatan TSD.
Selama proses pertumbuhan epitaksi SiC, TSD meluas dari substrat ke lapisan epitaksi. TSD yang diperluas dapat berubah menjadi cacat lain pada bidang substrat dan menyebar sepanjang sumbu pertumbuhan.
Telah ditunjukkan bahwa selama pertumbuhan epitaksi SiC, TSD diubah menjadi kesalahan lapisan bertumpuk (SF) atau cacat wortel pada bidang substrat, sedangkan TED pada lapisan epitaksi terbukti ditransformasikan dari BPD yang diwarisi dari substrat selama pertumbuhan epitaksi.
2. BPD
Dislokasi bidang basal (BPD), yang terletak pada bidang [0001] kristal SiC, memiliki vektor Burgers 1/3 <11-20>.
BPD jarang muncul di permukaan wafer SiC. Ini biasanya terkonsentrasi pada substrat dengan kepadatan 1500 1/cm2, sedangkan kepadatannya di lapisan epitaksi hanya sekitar 10 1/cm2.
Dapat dipahami bahwa kepadatan BPD menurun dengan meningkatnya ketebalan substrat SiC. Ketika diperiksa menggunakan photoluminescence (PL), BPD menunjukkan fitur linier. Selama proses pertumbuhan epitaksi SiC, BPD yang diperluas dapat diubah menjadi SF atau TED.
Dari penjelasan di atas, jelas bahwa terdapat cacat pada wafer substrat SiC. Cacat ini dapat diwariskan dalam pertumbuhan epitaksi film tipis, yang dapat menyebabkan kerusakan fatal pada perangkat SiC. Hal ini dapat menyebabkan hilangnya keunggulan SiC seperti medan tembus yang tinggi, tegangan balik yang tinggi, dan arus bocor yang rendah. Selain itu, hal ini dapat mengurangi tingkat kualifikasi produk dan menimbulkan hambatan besar bagi industrialisasi SiC karena berkurangnya keandalan.




