
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe dalam Manufaktur Chip: Laporan Berita Profesional
Evolusi Bahan Semikonduktor
Dalam bidang teknologi semikonduktor modern, dorongan tanpa henti menuju miniaturisasi telah melampaui batas-batas material berbasis silikon tradisional. Untuk memenuhi tuntutan kinerja tinggi dan konsumsi daya rendah, SiGe (Silicon Germanium) telah muncul sebagai material komposit pilihan dalam pembuatan chip semikonduktor karena sifat fisik dan listriknya yang unik. Artikel ini menyelidikiproses epitaksiSiGe dan perannya dalam pertumbuhan epitaksi, aplikasi silikon tegang, dan struktur Gate-All-Around (GAA).
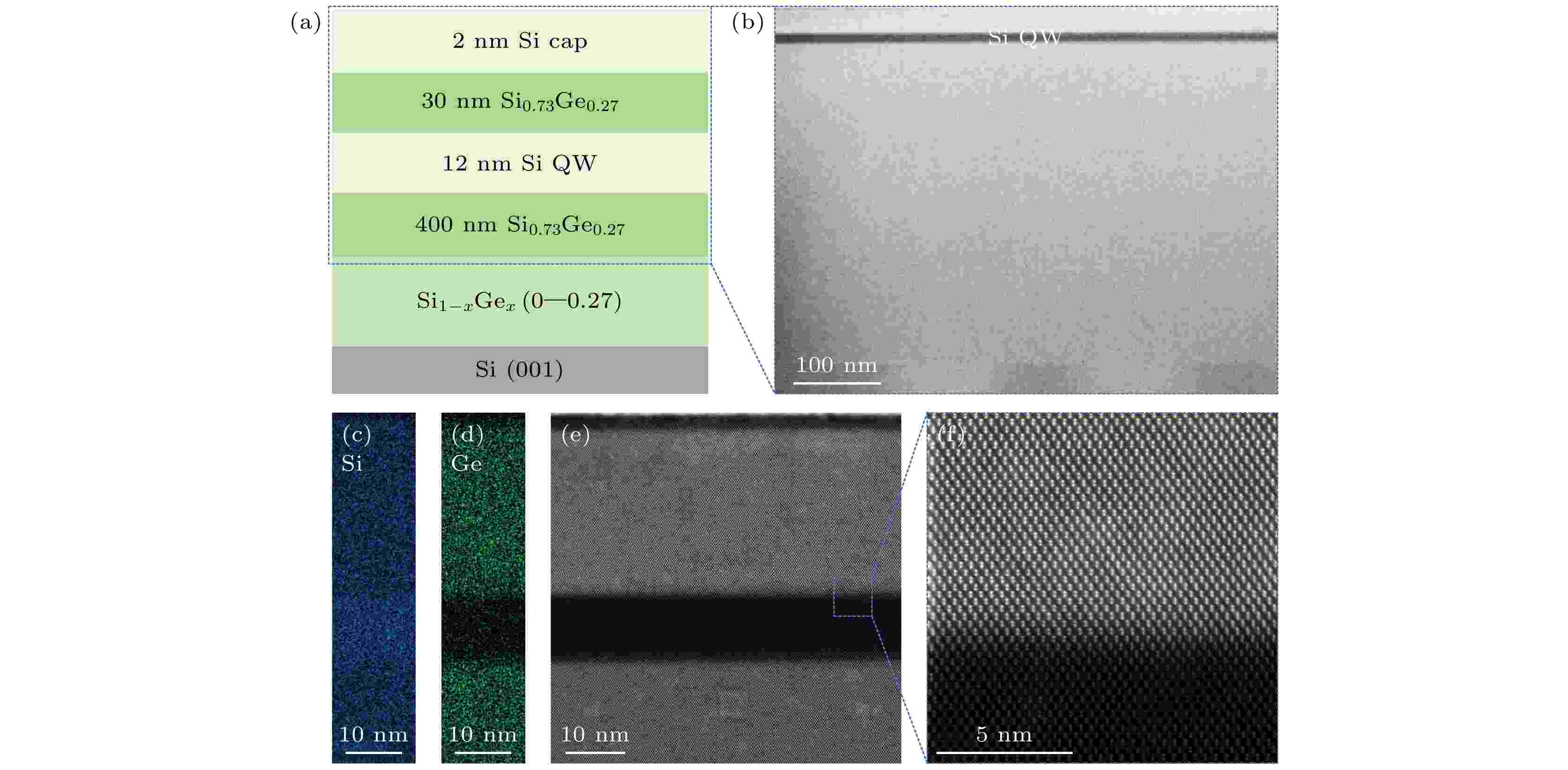
Pentingnya Epitaksi SiGe
1.1 Pengantar Epitaksi dalam Pembuatan Chip:
Epitaksi, sering disingkat Epi, mengacu pada pertumbuhan lapisan kristal tunggal pada substrat kristal tunggal dengan susunan kisi yang sama. Lapisan ini bisa berupa apa sajahomoepitaksial (seperti Si/Si)atau heteroepitaksial (seperti SiGe/Si atau SiC/Si). Berbagai metode digunakan untuk pertumbuhan epitaksi, termasuk Molecular Beam Epitaxy (MBE), Deposisi Uap Kimia Vakum Ultra Tinggi (UHV/CVD), Epitaksi Atmosfer dan Tekanan Berkurang (ATM & RP Epi). Artikel ini berfokus pada proses epitaksi silikon (Si) dan silikon-germanium (SiGe) yang banyak digunakan dalam produksi sirkuit terpadu semikonduktor dengan silikon sebagai bahan substrat.
1.2 Keuntungan Epitaksi SiGe:
Memasukkan proporsi tertentu germanium (Ge) selamaproses epitaksimembentuk lapisan kristal tunggal SiGe yang tidak hanya mengurangi lebar celah pita tetapi juga meningkatkan frekuensi cut-off transistor (fT). Hal ini membuatnya dapat diterapkan secara luas pada perangkat frekuensi tinggi untuk komunikasi nirkabel dan optik. Selain itu, dalam proses sirkuit terpadu CMOS tingkat lanjut, ketidaksesuaian kisi (sekitar 4%) antara Ge dan Si menimbulkan tekanan kisi, meningkatkan mobilitas elektron atau lubang dan dengan demikian meningkatkan arus saturasi perangkat dan kecepatan respons.
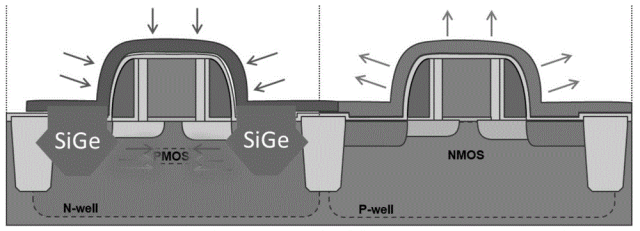
Alur Proses Epitaksi SiGe Komprehensif
2.1 Pra-perawatan:
Wafer silikon diolah terlebih dahulu berdasarkan hasil proses yang diinginkan, terutama melibatkan penghilangan lapisan oksida alami dan kotoran pada permukaan wafer. Untuk wafer substrat dengan doping berat, penting untuk mempertimbangkan apakah penyegelan balik diperlukan untuk mengurangi doping otomatis pada wafer berikutnya.pertumbuhan epitaksi.
2.2 Gas dan Kondisi Pertumbuhan:
Gas silikon: Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), dan Trichlorosilane (TCS, SiHCl₃) adalah tiga sumber gas silikon yang paling umum digunakan. SiH₄ cocok untuk proses epitaksi penuh bersuhu rendah, sedangkan TCS, yang dikenal dengan laju pertumbuhannya yang cepat, banyak digunakan untuk pembuatan kentalepitaksi silikonlapisan.
Gas Germanium: Germane (GeH₄) adalah sumber utama untuk menambahkan germanium, digunakan bersama dengan sumber silikon untuk membentuk paduan SiGe.
Epitaksi selektif: Pertumbuhan selektif dicapai dengan menyesuaikan tingkat relatifdeposisi epitaksidan etsa in situ, menggunakan gas silikon DCS yang mengandung klorin. Selektivitas ini disebabkan oleh adsorpsi atom Cl pada permukaan silikon lebih sedikit dibandingkan pada oksida atau nitrida, sehingga memfasilitasi pertumbuhan epitaksial. SiH₄, yang tidak memiliki atom Cl dan energi aktivasi rendah, umumnya hanya diterapkan pada proses epitaksi penuh bersuhu rendah. Sumber silikon lain yang umum digunakan, TCS, memiliki tekanan uap rendah dan berbentuk cair pada suhu kamar, sehingga memerlukan penggelembungan H₂ untuk memasukkannya ke dalam ruang reaksi. Namun, biayanya relatif murah dan sering digunakan karena laju pertumbuhannya yang cepat (hingga 5 μm/menit) untuk menumbuhkan lapisan epitaksi silikon yang lebih tebal, banyak digunakan dalam produksi wafer epitaksi silikon.
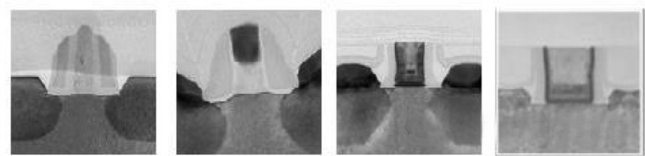
Silikon Tegang di Lapisan Epitaxial
Selamapertumbuhan epitaksi, Si kristal tunggal epitaksi diendapkan pada lapisan SiGe yang rileks. Karena ketidaksesuaian kisi antara Si dan SiGe, lapisan kristal tunggal Si mengalami tekanan tarik dari lapisan SiGe di bawahnya, yang secara signifikan meningkatkan mobilitas elektron pada transistor NMOS. Teknologi ini tidak hanya meningkatkan arus saturasi (Idsat) tetapi juga meningkatkan kecepatan respon perangkat. Untuk perangkat PMOS, lapisan SiGe ditanam secara epitaksial di daerah sumber dan saluran setelah pengetsaan untuk menimbulkan tekanan tekan pada saluran, meningkatkan mobilitas lubang dan meningkatkan arus saturasi.
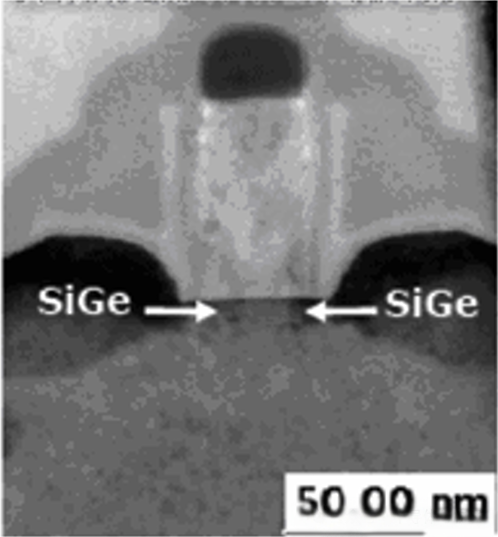
SiGe sebagai Lapisan Pengorbanan dalam Struktur GAA
Dalam pembuatan transistor kawat nano Gate-All-Around (GAA), lapisan SiGe bertindak sebagai lapisan korban. Teknik etsa anisotropik selektivitas tinggi, seperti etsa lapisan kuasi-atomik (quasi-ALE), memungkinkan penghilangan lapisan SiGe secara tepat untuk membentuk struktur kawat nano atau lembaran nano.
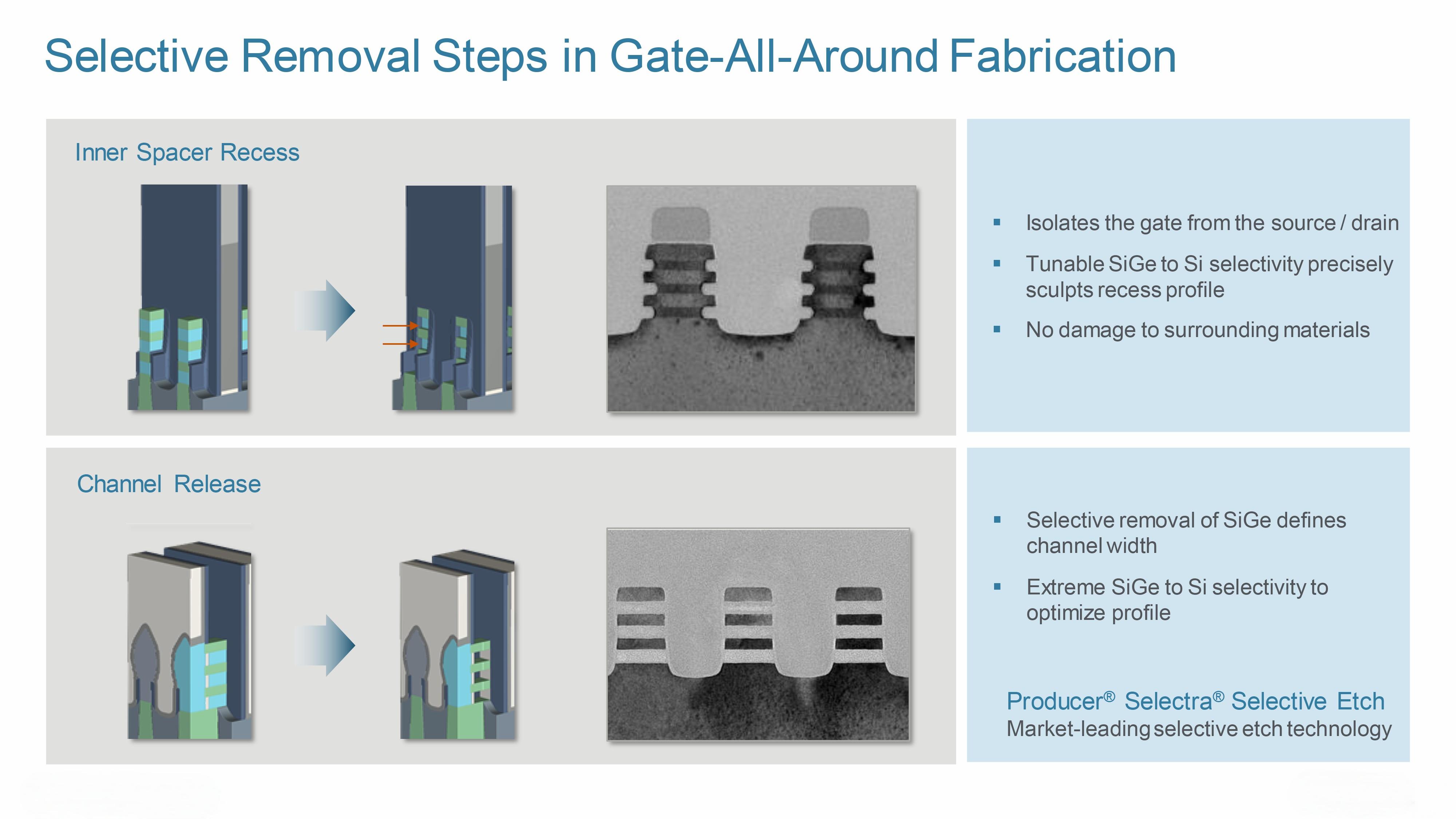
Kami di Semicorex berspesialisasi dalamLarutan grafit berlapis SiC/TaCditerapkan dalam pertumbuhan epitaksi Si dalam manufaktur semikonduktor, jika Anda memiliki pertanyaan atau memerlukan detail tambahan, jangan ragu untuk menghubungi kami.
Hubungi telepon: +86-13567891907
Email: penjualan@semicorex.com




